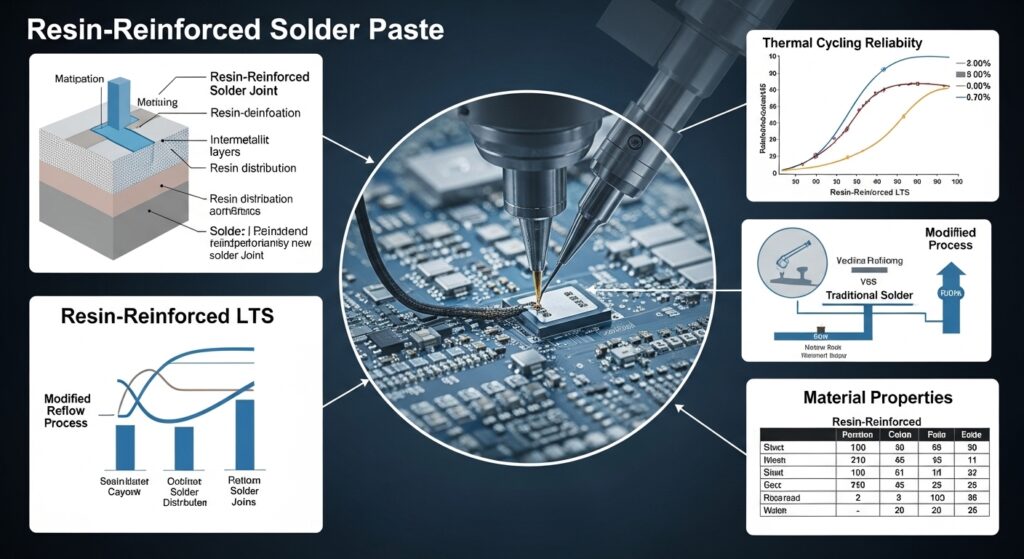
序論:電子実装における熱的パラダイムシフトと戦略的背景
グローバルな電子基板実装(SMT)業界は現在、環境的要請とパッケージングの微細化という二つの巨大な圧力によって、過去数十年間で最も急進的な冶金学的・プロセス工学的変革の只中にある。
2000年代初頭の鉛フリー化以降、業界標準として君臨してきたSn-Ag-Cu(SAC)系合金、とりわけSAC305は、優れた機械的強度と熱的信頼性を誇る一方で、217℃という高い融点を持つため、リフロー炉のピーク温度を240℃〜260℃の範囲に設定する必要があった。
しかし、この高温プロセスは、現代の電子機器製造において致命的な二つのボトルネックを生み出している。
すなわち、莫大なエネルギー消費に伴うカーボンフットプリントの増大と、基板の薄型化に伴う深刻な熱変形(反り:Warpage)の発生である。
これらの課題を根本的に解決するため、IntelやLenovoなどのグローバル企業が主導し、リフロー温度を200℃以下に引き下げる「低温はんだ(Low Temperature Solder:LTS)」の導入が急速に進められている。
主にスズ・ビスマス(Sn-Bi)系合金を中心とするこの技術は、製造プロセスの脱炭素化と歩留まりの向上において劇的な成果を上げている。
しかしながら、ビスマスを含む合金は本質的に「脆い(落下衝撃に弱い)」という致命的な冶金学的弱点を抱えており、これがモバイル機器などへの適用における最大の障壁となっていた。
この物理的脆弱性を克服するため、海外の先端材料メーカーを中心に「エポキシ樹脂を配合したフラックス(はんだペースト)」の採用が始まっている。
これが「樹脂補強型」低温はんだペースト(Resin-Reinforced LTS、またはJoint Reinforced Paste:JRP)である。
リフローの熱ではんだが溶融すると同時に、周囲のフラックスが熱硬化性樹脂として固まり、はんだ接合部を物理的に包み込んで補強(カプセル化)するこの技術は、従来のアンダーフィル工程を完全に省略できるため、生産タクトタイムの短縮に直結する次世代の消耗品として業界の耳目を集めている。
本報告書では、この樹脂補強型LTSの冶金学的メカニズム、プロセス工学上の最適化要件、iNEMIによる信頼性評価、および市場における実装動向について包括的かつ深層的な分析を提供する。
カーボンニュートラルと薄型基板の反り(Warpage)対策
LTSの導入を推進する原動力は、マクロ経済的な環境規制の遵守と、ミクロなパッケージング工学における歩留まり改善の要求という、全く異なる二つのベクトルから構成されている。
環境負荷の低減とエネルギー経済性
欧州連合(EU)の排出量取引制度(ETS)をはじめとするグローバルな気候変動対策は、電子機器メーカーに対してサプライチェーン全体での脱炭素化を強く要求している。
従来の高スズ系SAC合金を用いたリフロープロセスは極めてエネルギー集約的であり、継続的な高温維持に膨大な電力を消費する。
LTSの導入は、このエネルギー構造を劇的に改善する。IntelおよびLenovoの算出モデルによれば、従来のSAC305ペーストを使用した場合のリフロー炉の消費電力が約29.5 kWであるのに対し、Sn-Bi系LTSペーストに最適化されたリフロー炉の消費電力は17.8 kWまで低下する。これを標準的な稼働率(週134.4時間)で換算すると、オーブン1台あたり年間約57.2メートルトンのCO2排出量削減につながる。
特にLenovoは、2017年に特許出願中の新しいLTSプロセスを発表し、PC製造における二酸化炭素排出量を35%削減するという画期的なマイルストーンを達成した。この新プロセスを複数のSMTラインに展開することで、年間5,956メートルトンのCO2(ガソリン消費量換算で約67万ガロン相当)を削減できると推計されており、同社はすでにこの技術を用いて5,000万台以上のノートPCを製造している。このように、LTSは企業のESG(環境・社会・ガバナンス)目標の達成と、電力コストの直接的な削減を同時に実現する戦略的手段となっている。
動的熱反り(Dynamic Warpage)の抑制と歩留まり向上
エネルギー効率と並ぶもう一つの強力な導入要因が、半導体パッケージおよびプリント基板(PCB)の熱変形対策である。
スマートデバイスやモバイルPCの薄型化に伴い、フリップチップBGA(FCBGA)やPackage-on-Package(PoP)などの超薄型・高密度パッケージが多用されている。
これらのパッケージは、シリコンダイ、有機サブストレート、銅配線など、熱膨張係数(CTE)の異なる異種材料の積層によって構成されている。
240℃を超える従来のSACリフロー温度域では、このCTEの不整合によってパッケージとPCBが激しく相反する方向へ反り返る「動的熱反り」が発生する。
はんだが溶融している最中に基板と部品間のクリアランスが急激に変動すると、圧縮応力による隣接端子間のブリッジ(短絡)や、引張応力による未はんだ(Non-Wet-Open:NWO)、あるいはHead-in-Pillow(HiP)といった致命的な実装不良が引き起こされる。
リフローのピーク温度を190℃以下、理想的には170℃〜175℃の領域まで下げることにより、この動的熱反りを50%以上低減させることが可能となる。
部品と基板の平坦性が維持されることで、微細ピッチデバイスの実装歩留まりは飛躍的に向上し、同時にTg(ガラス転移点)の低い安価な基板材料を採用する余地も生まれるため、総所有コスト(TCO)の最適化にも寄与する。
Sn-Bi系合金の冶金学的脆弱性とハイブリッド接合の力学
リフロー温度の低下は多大なメリットをもたらすが、それに用いられるスズ・ビスマス(Sn-Bi)系合金は、電子部品の信頼性を脅かす深刻な物理的欠陥を内包している。
この脆弱性の理解なくして、樹脂補強の必要性を論じることはできない。
ビスマスによる脆化メカニズムと落下衝撃への脆弱性
LTSの主流である共晶または亜共晶Sn-Bi合金(代表例としてSn-58Bi)は、138℃という極めて低い融点を持つ。
スズ母相にビスマスを添加すると、固溶強化(Solid-solution strengthening)によってバルクはんだの引張強度や降伏応力は上昇するものの、引き換えに延性(Ductility)が著しく失われる。
ビスマスは本質的に脆い半金属であり、この合金系は外的な運動エネルギーを塑性変形によって吸収・散逸させることができない。
モバイル機器が落下した際などの高ひずみ速度(High strain rate)の衝撃荷重が加わると、塑性変形できないバルクはんだは応力をそのまま基板との界面にある金属間化合物(IMC)層(主にCu6Sn5など)へと伝達する。
さらに、凝固およびエージングの過程でビスマス原子はIMC界面に向かって偏析(Segregation)しやすく、界面にビスマスが集中した極めて脆弱な境界層を形成する。
その結果、落下衝撃を受けた際には、このビスマス偏析層に沿って界面破壊(脆性破壊)が容易に進行し、電気的接続が完全に絶たれるという致命的な弱点を抱えている。
異種金属混合(ハイブリッド)接合部の不安定性
現在の電子部品サプライチェーンにおける現実的な課題として、市販されているBGAやCSPコンポーネントの大部分は、あらかじめSAC305(融点約217℃)のはんだボールが搭載されている点が挙げられる。
このSACボール搭載部品を、170℃〜190℃のLTSリフロープロファイルで基板に実装する場合、SACボール自体は溶融しない。
その代わり、基板側に印刷されたSn-Biペーストのみが溶融し、固体状態のSACボールの下部を濡らしながら、ビスマス原子がSACボールの内部へと拡散していく。これにより、上部に未溶融のSAC領域(Bi欠乏層)、下部に溶融したSn-Bi領域(Bi富化層)を持つ「ハイブリッド(不均質)接合部」が形成される。
このハイブリッド構造は冶金学的に極めて不安定である。溶融時のビスマスの拡散度合いは、リフローのピーク温度や液相線以上の保持時間(TAL)に強く依存する。ビスマスの混合が不十分な場合、明確な境界面が応力集中源となり、逆に混合が進みすぎると、凝固時の収縮率の違いからコンポーネント側の界面近傍でホットティアリング(高温割れ)と呼ばれる微小クラックを誘発する。いずれにせよ、ハイブリッド接合部は均質なSAC接合部と比較して、落下衝撃や熱サイクルに対する耐性が著しく低いことが実証されている。
エポキシフラックスによる物理的補強(JRP)のメカニズム
上述したビスマス合金の「脆さ」という致命的な弱点を克服するため、海外の先端材料メーカーを中心に開発された革新的なアプローチが、「エポキシ樹脂を配合したフラックス」を用いた物理的補強技術である。
これは一般にResin-Reinforced LTS、またはJoint Reinforced Paste(JRP)と呼称される。
熱硬化反応とインシチュ(In-situ)カプセル化
JRPの核心的なイノベーションは、従来のロジン系フラックスを、高度に分子設計された熱硬化性エポキシフラックスマトリックスに置き換えた点にある。
この複合材料は、SMTリフロー炉の加熱プロファイルの中で、はんだ付けと樹脂硬化という二つの化学的・物理的プロセスを完璧に同期させるよう設計されている。
リフロー炉内で温度が上昇すると、まずフラックス内の有機酸活性剤が作用し、基板のパッドやコンポーネントの端子表面の酸化膜を除去する。
温度が138℃の閾値を超えると、Sn-Biはんだ粉末が溶融し、凝集して金属的な接合を形成し始める。
これと全く同時に、配合されたエポキシ樹脂システム(多くの場合、酸無水物系硬化剤や第3級アミン硬化促進剤を含む)が急激な粘度低下を起こし、溶融したはんだ接合部の周囲へと流動してフィレットを形成する。
その後、リフローのピーク温度に達し液相線以上の時間(TAL)が維持される間に、エポキシ樹脂の不可逆的な架橋重合(Cross-linking)反応が引き起こされる。
結果として、はんだが冷却されて凝固するのと同時に、周囲の樹脂が三次元的な高弾性ポリマーとして固まり、脆いはんだ接合部を物理的にすっぽりと包み込んでカプセル化する。
応力の再分配と電気化学的マイグレーションの抑制
硬化したエポキシフィレットは、脆いSn-Bi合金に対する強力な外骨格として機能する。
基板に曲げ応力や落下衝撃が加わった際、通常であれば脆弱なCu6Sn5/Bi界面に集中するはずの運動エネルギーは、周囲の高弾性ポリマーによって吸収・分散される。
これにより、接合部のせん断強度と引張強度は劇的に向上し、脆性破壊の発生を強力に抑制する。
また、物理的な補強にとどまらず、エポキシ樹脂によるカプセル化は環境耐性の面でも卓越した効果を発揮する。
個々の接合部が樹脂によって密閉されるため、外部からの水分、粉塵、不純物の侵入が遮断され、導電性陽極フィラメント(CAF)の成長や電気化学的マイグレーションが抑制される。
さらに、高電流密度下でのビスマス原子の移動(エレクトロマイグレーション現象)に対しても、強固な樹脂の壁が物理的な拘束力を与え、Bi相の粗大化やカーケンダルボイドの形成を遅延させる効果があることが確認されている。
アンダーフィル工程の省略と生産タクトタイムの革新
JRPが「次世代の消耗品」として製造業界から熱狂的な注目を集めている最大の理由は、信頼性の向上そのものよりも、それがもたらすプロセス経済性の劇的な改善、すなわち「アンダーフィル工程の完全な省略」にある。
One-Pass SMTがもたらす製造ラインの再構築
従来のモバイル機器向け高信頼性実装、特にPoPや微細ピッチBGAの組み立てにおいては、リフローはんだ付けの完了後に、独立した「毛細管流動型アンダーフィル(Capillary Underfill)」工程が必須であった。
これは、専用のディスペンサー装置を用いてチップの周囲に液状の樹脂を塗布し、毛細管現象によってチップ下部の隙間に樹脂を浸透させた後、さらに専用の硬化オーブンで長時間の二次加熱を行うという、極めて煩雑なプロセスである。
この後工程は、生産ラインにおける最大のボトルネック(律速段階)であり、ディスペンサーロボットの導入による莫大な設備投資、樹脂の充填待ち時間、長時間の硬化プロセスによるタクトタイムの増大を引き起こしていた。
また、フラックス残渣とアンダーフィル樹脂の化学的相性によっては、流動阻害やボイドの発生という品質リスクも常に存在していた。
樹脂補強型はんだペースト(JRP)は、この常識を覆す。
フラックス自体がアンダーフィルの役割を果たすため、印刷、マウント、リフローという単一のSMTプロセス(One-pass reflow)を通過するだけで、はんだ付けと物理的補強が同時に完了する。
二次硬化工程が不要になることで生産タクトタイムは劇的に短縮され、ディスペンサーや硬化オーブンが占有していた工場内の設置面積(フットプリント)も削減される。
また、フラックスと樹脂が最初から一体化しているため、材料の不適合によるボイドリスクも原理的に排除される。
リワーク性(修復性)の確保
従来の毛細管流動型アンダーフィルのもう一つの欠点は、一度硬化すると部品の取り外し(リワーク)が極めて困難になることである。強引に部品を剥がせば、基板側の銅パッドごと剥離(パッドクレーター)してしまうことが多い。
これに対し、最新のエポキシフラックスシステムはリワーク性を考慮して設計されている。BGAリワークステーションやホットエアーを用いて局所的に加熱すると、熱硬化性フラックス残渣は液状にはならないものの、柔らかいゲル状に軟化する。この状態でコンポーネントを取り外すことで、基板へのダメージを防ぐことができる。その後、基板を約150℃に予熱し、溶剤(MEKや専用の洗浄液)を含ませたスワブでゲル状の樹脂を物理的に拭き取ることで、安全なサイトドレッシング(パッドの清掃)が可能である。樹脂を拭き取る手間は追加されるものの、高価な基板やアセンブリ全体を廃棄することなく修復できる点は、量産工場において大きな経済的利点となる。
iNEMI LTSPRプロジェクトにおける客観的信頼性評価
JRP技術の客観的な信頼性を検証するため、国際電子実装イニシアティブ(iNEMI)は2015年より「低温はんだプロセスおよび信頼性(LTSPR)プロジェクト」を始動した。
このプロジェクトには、Intel、Lenovo、Nokia、DellなどのOEMや、MacDermid Alpha、Indium、Senjuなどの主要材料メーカーが結集し、かつてない規模でのハイブリッド接合部の評価が行われた。
評価材料のカテゴライズと落下衝撃試験
iNEMIは評価対象のLTSペーストを以下の3つのカテゴリーに分類した。
- Bi-Sn Baseline(共晶系): 銀(Ag)を0〜1wt%添加した標準的なSn-58Bi合金。
- Ductile Bi-Sn(延性向上系): 結晶粒の微細化や析出強化を狙い、微量元素(Ni, Sb, Coなど)をドーピングしてバルクの靭性を高めた合金。
- JRP(樹脂補強型): エポキシ樹脂を配合したペースト(プロジェクト内コードネーム:Beserah, Golden Pillow, Chanee, Horlor)。
JEDEC JESD22-B111A規格に準拠した落下衝撃試験(14x14mm CABGA192などを搭載したテストボードを使用)の結果は、JRPの圧倒的な優位性を証明した。
標準的なSn-Biペーストは、予測通り数回の落下でBi偏析界面から脆性破壊を起こした。ドーパントを添加した延性向上系ペーストも一定の改善は見られたものの、SAC305のベースラインには遠く及ばなかった。
しかし、JRPに分類されるペーストは、特性寿命(Weibullプロットにおけるη)を飛躍的に延ばし、衝撃波を樹脂が吸収するメカニズムの有効性を実証した。特に「Beserah」と名付けられたペーストは、LTS群の中で最高の実績を叩き出し、SAC305の落下耐性に肉薄する結果を示した。
さらに興味深いのは、Dye-and-Pull(染色・牽引)法による故障解析におけるクラックモードの移行である。樹脂補強のないSn-Bi接合部では、破壊は常にIMC界面での脆性破壊であった。
しかし、JRPによって強固にカプセル化された接合部では、はんだ接合部自体の強度がPCBの誘電体(ガラスエポキシ樹脂)の破壊靭性を上回り、基板の銅パッドごと引きちぎられる「パッドクレーター(Pad Cratering)」へと主要な故障モードがシフトしたのである。
これは、はんだ付け部を衝撃から守るという樹脂補強の目的が完全に達成されていることを示している。
以下の表は、iNEMIのデータを基にした各ペーストカテゴリーの相対的な衝撃特性の比較である。
| ペーストカテゴリー | 代表的な組成 | エポキシカプセル化 | 相対的な落下衝撃耐性 (JEDEC) | 主要な破壊モード |
| SACベースライン | SAC305 | なし | 高(基準値) | パッドクレーター / バルクはんだ降伏 |
| 共晶 LTS | Sn-58Bi | なし | 最低(早期破壊) | 脆性界面破壊(IMC/Bi相) |
| 延性強化 LTS | Sn-Bi-X(ドーパント) | なし | 中 | 混合型(脆性・延性)IMC破壊 |
| JRP(樹脂補強型LTS) | Sn-Bi + エポキシフラックス | あり(ポリマーフィレット) | 高(SACベースラインに近似) | パッドクレーター / ソルダーレジスト剥離 |
熱疲労と温度サイクル試験(ATC)のインサイト
熱疲労を評価する温度サイクル試験(0℃〜100℃および-15℃〜85℃)においても、JRPは特筆すべき性能を示した。ハイブリッド接合部では、熱膨張係数の違いによる反復的なせん断応力がかかると、Biが密集した領域が塑性流動を起こす「ソルダーボールドリフト」という現象が観察される。
しかし、JRP(特にBeserahおよびGolden Pillow 2)を使用したアセンブリは、0℃/100℃のプロファイルにおいてSAC305ベースラインを上回る特性寿命と高い1%累積故障値を示した。
これは、樹脂フィレットが物理的な拘束具として働き、熱膨張に伴うせん断応力からはんだ接合部が引き裂かれるのを防いでいることを示唆している。
ただし、-15℃を含むより過酷な低温プロファイルにおいては、極低温下でのポリマーの収縮により、ソルダーレジストからの樹脂の剥離(密着性の低下)が懸念されるデータも一部見られ、樹脂材料の低温特性にはさらなる最適化の余地があることが分かっている。
実装プロセス工学における最適化変数と管理指標
樹脂補強型はんだペーストの導入は、従来のSACプロセスとは異なる独特のレオロジー(流動学)的・熱力学的な変数をSMTラインに持ち込むため、厳密なプロセス制御が要求される。
リフロープロファイルの再定義:「台形トポグラフィー」
JRPのプロセスエンジニアリングにおいて最も重要かつ困難な課題は、はんだの溶融速度とエポキシ樹脂のゲル化速度を完璧に同調させることである。もしリフロー炉の昇温速度(ランプレート)が遅すぎると、はんだ粉末が溶融して部品の端子を濡らす前に、エポキシ樹脂が熱反応を起こして架橋(ゲル化)してしまう。この「早期ゲル化」が発生すると、硬化した樹脂が物理的な障壁となってはんだの濡れ広がりを阻害し、深刻な「部分濡れ(Partial Wetting)」やHiP欠陥を引き起こす。
この現象を回避するため、JRPのリフロープロファイルでは、従来行われていた「プリヒート(ソーク)ゾーン」を完全に排除した「台形トポグラフィー(Trapezoidal Topography)」と呼ばれるアグレッシブな直線的プロファイルが推奨される。具体的には、初期の昇温速度を毎秒3℃以上の急峻なペースに設定し、ポリマーがゲル化点に達するよりも早くはんだを液相線温度に到達させることが不可欠である。また、接合完了後は、エポキシ樹脂のガラス転移点(Tg)を最大化し十分な機械的強度を引き出すため、液相線以上の時間(TAL)を標準的なLTSよりも長めに保持する必要がある。
印刷ダイナミクスと粘度制御
エポキシ樹脂の添加は、はんだペーストのチキソトロピー(揺変性)にも影響を与える。
印刷性を確保しつつ、補強に必要なポリマー体積を維持するため、JRPのメタル含有率(Metal Load)は通常のペーストよりもやや低めの83%〜92%の範囲で調整されることが多い。
連続印刷における安定性は高いものの、極小の開口部(アスペクト比の低い微細ピッチ)においては、エポキシの粘性によって版抜けが悪化する傾向がある。
iNEMIのデータによれば、ステンシル開口面積比が0.50付近まで低下すると、JRPは標準的なペーストと比較して転写効率が著しく低下し、印刷体積のばらつき(変動係数)が大きくなることが確認されている。
したがって、01005サイズのチップや微細ピッチBGAを実装する際には、ステップステンシルの活用や、スキージ印圧(例:0.018~0.027 kg/mm)の最適化など、高度な印刷プロセス設計が要求される。
グローバル材料メーカーによる商用化とエコシステムの構築
iNEMIの研究成果を基盤として、現在、世界のトップティア材料メーカー各社が独自の樹脂化学と合金設計を融合させた商用JRP製品を市場に投入している。
MacDermid Alpha Electronics Solutions
同社はLTS領域において極めて積極的な製品展開を行っている。主力製品であるALPHA OM-565 HRL3は、独自のHRL3合金と樹脂親和性の高いフラックスを組み合わせたペーストである。
175℃という低いピーク温度で次世代CSPの動的熱反りによるHiPやNWOを抑制しつつ、微量元素のドーピングによってSn-Bi単体よりも本質的に高い落下衝撃耐性を実現している。
さらに、ゼロハロゲン処方で8時間のステンシルライフを持ち、リワーク用途の材料とも優れた互換性を持つ。
また、ジェットディスペンサー向けには、融点138℃のエポキシフラックスベースペーストALPHA JP-501を提供しており、Mycronic社のジェットプリンター等に最適化されている。
Indium Corporation
Indium社は、合金のドーピングと高度なエポキシマトリックスの双方からアプローチしている。
同社の特許技術であるDurafuse LTは、低融点のインジウム含有粉末と高融点のSAC粉末を混合したユニークな系を採用している。
210℃以下のリフローでインジウム合金が先に溶融し、それが毛細管現象のようにSAC粉末を溶かし込むことで、LTSの低温実装メリットを享受しつつ、SAC305と同等の卓越した落下衝撃耐性を発揮する。
純粋なSn-Bi系を求める用途には、ドーピングによる熱疲労耐性向上合金(Bi+ / Indalloy 301等)と互換性のあるIndium 5.7LT-1シリーズを展開し、優れたボイド制御と印刷性を実現している。
千住金属工業(Senju Metal Industry / SMIC)
千住金属工業は、はんだ付けとアンダーフィル工程を一度のプロセスで完了させる「接合補強ペースト」としてJPPシリーズを展開している。
JPPシリーズはフラックス中にエポキシ樹脂を含有しており、印刷後に部品をマウントすると毛細管現象によってフラックスが部品下部へ回り込む。
リフロー熱によって樹脂が硬化し、脆いSn-Biはんだの落下衝撃耐性と熱サイクル耐性を劇的に向上させる。特に、ポリアミドやPETのような曲げ応力がかかりやすいフレキシブル基板(FPC)において、接合部の破壊を防ぐ強力なソリューションとして位置づけられている。
タムラ製作所、日本スペリア社、ハリマ化成
アジアの材料メーカーもLTS技術の拡大に大きく貢献している。
日本スペリア社(SN100Cで著名)やタムラ製作所はiNEMIのプロジェクトにも参画しており、部分加熱やレーザーはんだ付けに対応した独自の低温・樹脂補強ソリューションを提供している。
ハリマ化成は、松脂(ロジン)誘導体の化学的知見を活かし、フラックス機能と熱硬化性エポキシ樹脂を高度にブレンドした無VOCのエポキシフラックスを開発している。
はんだの酸化膜を除去しつつ、リフロー後に強固かつ柔軟性のある補強フィルムを形成する技術で特許を有している。
境界条件と高TDP環境における熱力学的限界
ラボレベルでの成功と商用化を経て、樹脂補強型LTSは世界の消費者向け電子機器市場において大規模なストレステストを受けている。これは巨大な環境的成果をもたらした一方で、Sn-Bi冶金システムの熱力学的な限界も明確に浮き彫りにしている。
Lenovoによる歴史的な量産実績
LenovoによるLTSの量産導入は、グリーンエレクトロニクス製造における記念碑的な成功例である。同社はThinkPadやThinkBookシリーズなどの主要製品ラインにおいて、樹脂補強アプローチを含むLTSプロセスを採用し、これまでに5,000万台以上のノートPCを製造してきた。これにより、SMT関連の温室効果ガス排出量を実証可能な形で35%削減することに成功している。リフロー時の熱変形が排除されたことで、マザーボード設計における基板ピッチの縮小や、01005サイズの微小受動部品、および極薄のIntel CPUサブストレートの高い初回歩留まりを達成した。この大規模な展開は、熱制御が適切に行われるデバイスにおいてLTSが極めて有効であることを証明している。
高消費電力(High-TDP)プロセッサにおける熱疲労の壁
しかしながら、市場からのフィードバックは、Sn-Bi合金の本質的な熱力学的限界(境界条件)を明らかにしている。
ハイエンドのゲーミングPCなどに搭載される先進的なプロセッサ(例えばAMDのRyzen 7シリーズなど)は、熱設計電力(TDP)が45Wを容易に超える。
冷却機構が不十分な環境で高負荷の演算が行われると、チップパッケージのジャンクション温度は急激に上昇し、わずか15分程度で98℃近くに達することがある。
98℃という温度は、Sn-Bi合金の絶対融点(138℃)の約70%以上(絶対温度表記に基づく相同温度:Homologous temperature)に相当する。
このような極端に高い相同温度環境下では、金属格子のクリープ変形やエレクトロマイグレーションが指数関数的に加速する。
実際の修理現場のデータによれば、2000回程度の過酷な熱サイクル(一般ユーザーの約半年分の使用に相当)を超えると、Sn-Biマトリックス内部でBi相の急速な粗大化と微小クラックの伝播が発生する。
エポキシ樹脂によるカプセル化は、落下衝撃(運動エネルギー)や中程度の熱サイクル(0/100℃)に対しては完璧な防壁として機能するものの、合金そのものが融点近くまで熱せられ、基板と発熱するシリコンダイの間の熱膨張差に長期間晒された場合、最終的にははんだ層の内部から破壊が進行してしまう。
この問題に対処するため、プロフェッショナルな修理業者の中には、マザーボードを加熱してアルコールでブラックグルー(補強樹脂)を軟化・除去した上で、チップを外し、高融点のSAC305はんだボールを用いて再リボール(Reballing)するという標準化された修理プロセスを確立しているケースもある。
この相反する事実は、樹脂補強型LTSの適用領域を明確に定義している。
基板の反り対策が最優先され、かつ動作温度が厳密に管理される薄型・軽量のモバイルデバイスや標準的なビジネスノートPCにおいては、JRPは理想的なソリューションである。
しかし、高ワット数の演算処理を行うサーバー、ゲーミングPC、あるいは過酷な温度環境に晒される車載エレクトロニクスにおいては、依然として従来のSAC305合金と伝統的な毛細管流動型アンダーフィルの組み合わせが必須要件となっている。
結論
「樹脂補強型」低温はんだペースト(Resin-Reinforced LTS / Epoxy Flux)の実用化は、現代の表面実装技術(SMT)において最も重要な技術的転換点の一つである。
薄型化による異種材料パッケージの動的熱反り(Warpage)の抑制と、グローバルな脱炭素化(カーボンニュートラル)という二つの至上命題に突き動かされ、業界は138℃というSn-Bi系冶金システムの低い融点閾値を見事に制御することに成功した。
最大の障壁であった「ビスマスによる脆化・落下衝撃への弱さ」を中和するため、材料科学は冶金学と有機ポリマー化学を融合させた。
熱硬化性エポキシ樹脂をフラックスマトリックスに直接統合することで、はんだの溶融・金属結合と同時に、衝撃を吸収し環境変化を遮断する強固なポリマーシェルを形成する「One-pass reflow(単一通過リフロー)」プロセスが実現した。
これにより、Sn-Biの脆性をエレガントに迂回し、落下衝撃耐性を従来のSAC305と同等レベルにまで引き上げると同時に、時間と設備投資を浪費する毛細管流動型アンダーフィル工程を完全に排除し、生産タクトタイムの抜本的な短縮を可能にした。
iNEMIによる徹底した信頼性評価の裏付けを得て、MacDermid Alpha、Indium、千住金属工業といったグローバル材料メーカーによって製品化されたこの技術は、Lenovoの5,000万台に及ぶ導入実績が示す通り、すでに消費者向け電子機器のエコロジカル・フットプリントを劇的に塗り替えつつある。
現状では、高TDPプロセッサにおける熱力学的限界(高相同温度でのクリープや疲労)という課題が適用範囲を制限しているものの、エポキシ樹脂の分子設計や合金ドーパントのさらなる進化により、樹脂補強型LTSはその運用限界を継続的に拡大し、次世代の持続可能なエレクトロニクス製造を支える中核的な消耗品(ソリューション)としての地位を確固たるものにしていくと予測される。
引用ソース
- Will LTS Process be the Mainstream in the Future?, https://www.dekra-ist.com/article_d.php?lang=en&tb=3&cid=334&id=2045
- MECHANICAL SHOCK AND DROP RELIABILITY EVALUATION OF THE BGA SOLDER JOINT STACK-UPS FORMED BY REFLOW SOLDERING SAC SOLDER BALLS B – Circuit Insight, https://www.circuitinsight.com/pdf/mechanical_shock_drop_reliability_smta.pdf
- Investigation of Low Temperature Solders to Reduce Reflow Temperature, Improve SMT Yields and Realize Energy Savings,https://www.electronics.org/system/files/technical_resource/E38%26S14-03%20-%20Scott%20Mokler.pdf
- Verifying Low-Temperature Soldering Compliance For CO2 Savings And Enhanced Product Performance – Semiconductor Engineering, 、 https://semiengineering.com/verifying-low-temperature-soldering-compliance-for-co2-savings-and-enhanced-product-performance/
- Interfacial Reaction and Mechanical Properties of Sn-Bi Solder joints – PMC, https://pmc.ncbi.nlm.nih.gov/articles/PMC5578286/
- EPOXY FLUX MATERIAL AND PROCESS FOR ENHANCING ELECTRICAL INTERCONNECTIONS – Circuit Insight,https://www.circuitinsight.com/pdf/epoxy_flux_material_process_smta.pdf
- solder joint reliability on mixed sac-bisn ball grid array solder joints formed with resin reinforced bi-sn metallurgy solder pastes – Circuit Insight,https://www.circuitinsight.com/pdf/Solder_Joint_Reliability_Mixed_SAC-BISN_Ball_Grid_Array_Solder_Joints_Formed_With_Resin_Reinforced_BI-SN_Metallurgy_Solder%20Pastes_smta.pdf
- Epoxy flux a low cost high reliability approach for pop assembly-imaps 2011 – Slideshare, https://www.slideshare.net/slideshow/epoxy-flux-a-low-cost-high-reliability-approach-for-pop-assemblyimaps-2011/9930012
- Epoxy Flux: Exploring the Most Versatile, Low-Cost Approach for High Reliability in PoP Assembly, https://www.us-tech.com/RelId/1395434/ISvars/default/Epoxy_Flux_Exploring_the_Most_Versatile_Low_Cost_Approach_for_High_Reliability_in_PoP_Assembly.htm
- Will LTS Process be the Mainstream in the Future?-iST-Integrated Service Technology, https://www.istgroup.com/en/tech_20211214-lts/
- New Lenovo LTS Lowers Melting Temp, Cuts CO2 Emissions – Circuits Assemblyhttps://circuitsassembly.com/ca/editorial/menu-news/27004-new-lenovo-lts-lowers-melting-temp-cuts-co2-emissions.html
- Introduction to Low Temperature Soldering – Intelhttps://www.intel.com/content/dam/www/public/us/en/documents/presentation/low-temperature-soldering-introduction.pdf
- Lenovo Announces Breakthrough, Innovative PC Manufacturing Process,https://news.lenovo.com/pressroom/press-releases/lenovo-announces-breakthrough-innovative-pc-manufacturing-process/
- Superior business outcomes driven by a smarter approach to sustainability – Lenovo Tech Today https://techtoday.lenovo.com/sites/default/files/2023-12/Smarter_Solutions_DWS_Sustainability_Article.pdf
- Product Carbon Neutrality Report – Lenovo, 2月 28, 2026にアクセス、 https://www.lenovo.com/content/dam/lenovo/site-design/sustainability/Fiscal%20Year%20202324%20Product%20Carbon%20Neutrality%20Report%20V2%202.pdf
- Ball Grid Array (BGA) Packaging – Intel, https://www.intel.com/content/dam/www/public/us/en/documents/packaging-databooks/packaging-chapter-14-databook.pdf
- Impact of Low Temperature Solder on Electronic Package Dynamic Warpage Behavior and Requirement – INEMI.org https://thor.inemi.org/webdownload/2020/Q3/LTS-Warp/ECTC2019_LTS_warpage.pdf
- ALPHA® OM-565 HRL3 Solder Pastehttps://www.macdermidalpha.com/products/circuit-board-assembly/surface-mount-technology/solder-pastes/alpha-om-565-hrl3-solder-paste
- ALPHA OM-565 HRL3 Solder Paste Technical Data Sheet,https://www.macdermidalpha.com/sites/default/files/2025-04/ALPHA-OM-565-HRL3-SDP-TDS-GL-EN-26Nov2024.pdf
- ALPHA JP-501 – MacDermid Alpha Electronics Solutions | Solder Paste – PCB Directory, https://www.pcbdirectory.com/equipment/products/solder-paste/macdermid-alpha-electronics-solutions/43-268-alpha-jp-501
- ALPHA® JP-501 – MacDermid Alpha, https://www.macdermidalpha.com/products/circuit-board-assembly/surface-mount-technology/solder-pastes/alpha-jp-501
- Drop shock results of Sn-Bi alloys. | Download Scientific Diagram – ResearchGate, https://www.researchgate.net/figure/Drop-shock-results-of-Sn-Bi-alloys_fig11_321267564
- Strain Rate Sensitivity of Mixed SAC-SnBi Solder Joints – Allen Press, https://meridian.allenpress.com/ism/article/2019/1/000480/433122/Strain-Rate-Sensitivity-of-Mixed-SAC-SnBi-Solder
- Drop Shock Reliability of Lead-Free Alloys – Effect of Micro-Additives –https://smtnet.com/library/files/upload/drop-shock-reliability-alloys.pdf
- EFFECT OF SOLDER COMPOSITION, PCB SURFACE FINISH AND SOLDER JOINT VOLUME ON DROP SHOCK RELIABILITY – Circuit Insight, https://www.circuitinsight.com/pdf/Effect_Solder_Composition_PCB_Surface_Finish_Solder_Joint_Volume_drop_Shock_Reliability_smta.pdf
- Interim Thermal Cycling Report on Hybrid, Homogeneous, and Resin Reinforced Low Temperature Solder Joints – ResearchGate,https://www.researchgate.net/publication/359171466_Interim_Thermal_Cycling_Report_on_Hybrid_Homogeneous_and_Resin_Reinforced_Low_Temperature_Solder_Joints
- POST MECHANICAL SHOCK FAILURE ANALYSIS ON MIXED BiSn – SAC BGA SOLDER JOINTS OF POP COMPONENTS – iNEMI,https://thor.inemi.org/webdownload/2019/PanPac2019/PanPac-LTSolder.pdf
- (PDF) iNEMI project on process development of BISN-based low temperature solder pastes — Part II: Characterization of mixed alloy BGA solder joints – ResearchGate, https://www.researchgate.net/publication/323863544_iNEMI_project_on_process_development_of_BISN-based_low_temperature_solder_pastes_-_Part_II_Characterization_of_mixed_alloy_BGA_solder_joints
- Effect of some N-heterocyclic inhibitors in the soldering flux on the corrosion behavior of eutectic Sn–58Bi alloy and its solder paste – R Discovery, https://discovery.researcher.life/article/effect-of-some-nheterocyclic-inhibitors-in-the-soldering-flux-on-the-corrosion-behavior-of-eutectic-sn58bi-alloy-and-its-solder-paste/8255f0003e3a3adba9e023bcebbe3b5b
- Sn-Bi Low-Temperature Homogeneous Solder Joint Microstructure, Reliability and Failure Mechanism – Circuits Assembly, https://www.circuitsassembly.com/ca/editorial/menu-features/32850-sn-bi-low-temperature-homogeneous-solder-joint-microstructure-reliability-and-failure-mechanism.html
- Microstructure and Shear Behaviour of Sn-3.0Ag-0.5Cu Composite Solder Pastes Enhanced by Epoxy Resin – ResearchGate, https://www.researchgate.net/publication/366024317_Microstructure_and_Shear_Behaviour_of_Sn-30Ag-05Cu_Composite_Solder_Pastes_Enhanced_by_Epoxy_Resin
- Microstructure and Shear Behaviour of Sn-3.0Ag-0.5Cu Composite Solder Pastes Enhanced by Epoxy Resin – PMC, https://pmc.ncbi.nlm.nih.gov/articles/PMC9735467/
- ultra-fine epoxy solder paste – Shenzhen Fitech,https://en.szfitech.com/productinfo16.html
- Low-Temperature Ultra-Fine Epoxy Solder Paste-Shenzhen Fitech Co., Ltd.,https://www.fitech-solderpaste.com/ultra-fine-epoxy-solder-paste/low-temperature-ultra-fine-epoxy-solder-paste.html
- Study on the Reliability of Sn–Bi Composite Solder Pastes with Thermosetting Epoxy under Thermal Cycling and Humidity Treatment – MDPIhttps://www.mdpi.com/2073-4352/11/7/733
- Board Level Drop Test for Evaluating the Reliability of High-Strength Sn–Bi Composite Solder Pastes with Thermosetting Epoxy – MDPI, https://www.mdpi.com/2073-4352/12/7/924
- Epoxy Flux on POP Laminated Packages – Solder paste, https://www.fitech-solderpaste.com/industry-news/epoxy-flux-on-pop-laminated-packages.html
- Research Overview on the Electromigration Reliability of SnBi Solder Alloy – PMC,https://pmc.ncbi.nlm.nih.gov/articles/PMC11205207/
- Epoxy Flux- A Low Cost High Reliability Approach for PoP Assembly https://imapsource.org/api/v1/articles/56400-epoxy-flux-a-low-cost-high-reliability-approach-for-pop-assembly.pdf
- Epoxy Flux Rework Procedure and Clean-up – Indium Corporation, https://www.indium.com/blog/epoxy-flux-rework-procedure-and-clean-up/
- iNEMI Project Report on Process Development of BiSn-Based Low-Temperature Solder Pastes,https://thor.inemi.org/webdownload/2017/SMTAI_BiSn-Based_Low-Temp_Solder_Pastes_022017.pdf
- iNEMI PROJECT ON PROCESS DEVELOPMENT OF BiSn-BASED LOW, https://thor.inemi.org/webdownload/2020/SMTAI_2020/LTSPR_paper.pdf
- iNEMI Project on Process Development of BiSn-Based Low Temperature Solder Pastes – ResearchGate, https://www.researchgate.net/profile/Richard-Coyle/publication/325915485_iNEMI_project_on_process_development_of_BiSn-based_low_temperature_solder_pastes_Part_III_Mechanical_shock_tests_on_POP_BGA_assemblies/links/5edcef2692851c9c5e8b1881/iNEMI-project-on-process-development-of-BiSn-based-low-temperature-solder-pastes-Part-III-Mechanical-shock-tests-on-POP-BGA-assemblies.pdf
- Mechanical Shock Testing and Failure Analysis on Mixed SnAgCu-BiSn and Full Stack BiSn Solder Joints of CABGA192 Components – iNEMIhttps://thor.inemi.org/webdownload/2021/SMTAI/Mechanical_shock-paper.pdf
- Mechanical Shock Drop Reliability of BiSn Low Temperature Solders (LTS) – iNEMI, https://thor.inemi.org/webdownload//2021/BdAssy-Tech_Topics/BA_Mech_Shock_Drop_LTS.pdf
- iNEMI PROJECT ON PROCESS DEVELOPMENT OF BISN-BASED LOW TEMPERATURE SOLDER PASTES – PART IV: COMPREHENSIVE MECHANICAL SHOCK TEST, https://thor.inemi.org/webdownload/2018/SMTAI_2018/Aspandiar_paper.pdf
- Thermal Cycling Profile on Thermal Fatigue Performance of a 192-Pin Chip Array BGA – Circuitnethttps://www.circuitnet.com/programs/56323.html
- The Effect of Thermal Cycling Profile on Thermal Fatigue Performance of a 192-Pin Chip Array BGA with Hybrid, Homogeneous – Circuit Insight, https://www.circuitinsight.com/uploads/2/effect-thermal-cycling-profile-thermal-fatigue-performance-192-pin-chip-array-bga-smta.pdf
- Low Reflow Temp – Epoxy Solder Paste, https://epoxysolderpaste.com/epoxy-solder-paste-low-temp.html
- THE EFFECT OF THERMAL CYCLING PROFILE ON THERMAL FATIGUE PERFORMANCE OF A 192-PIN CHIP ARRAY BGA WITH HYBRID, HOMOGENEOUS, AND R – Circuit Insight https://www.circuitinsight.com/uploads/2/effect-thermal-cycling-profile-thermal-fatigue-performance-84-pin-thin-core-bga-smta.pdf
- Durafuse® LT with Indium5.7LT-1 – Indium Corporation, https://www.indium.com/wp-content/uploads/2025/03/Durafuse-LT-Low-Temperature-Indium5.7LT-1-PDS-99734-R6-1.pdf
- Indium5.7LT-1 with Indalloy®301 – Indium Corporation, https://www.indium.com/wp-content/uploads/2025/03/Indium5.7LT-1-with-Indalloy301-Low-Temperature-Solder-Paste-PDS-100133-A4-R0-1.pdf
- Indium5.7LT – Solder Paste – Indium Corporation,https://www.indium.com/wp-content/uploads/2025/03/Indium5.7LT-Solder-Paste-PDS-98590-A4-R7-1.pdf
- SMTA International – Accepted Speakers, https://smta.org/mpage/smtai-speakers-accepted
- MacDermid Alpha to Spotlight Reliability and Sustainability in Automotive Electronics at Productronica India https://www.macdermidalpha.com/news/macdermid-alpha-spotlight-reliability-and-sustainability-automotive-electronics-productronica-india
- Low Temperature | Solder Paste – Indium Corporation,https://www.indium.com/products/solder-paste/pcba-assembly/low-temperature-solder-pastes/
- Solder Paste – Indium Corporation https://www.indium.com/products/solder-paste/
- Durafuse® | Indium Corporation,https://www.indium.com/products/durafuse/
- Durafuse LT | Low-Temperature Solder – Indium Corporation,https://www.indium.com/products/alloys/solder-alloys/durafuse-lt/
- Indium5.7LT-1 with Indalloy®303 (Bi+) – Indium Corporation,https://www.indium.com/wp-content/uploads/2025/03/Indium5.7LT-1-with-Indalloy303-Bi-Enhanced-Low-Temperature-Solder-Paste-PDS-99862-A4-R1-1.pdf
- Solder paste | Soldering Materials | Products | Senju Metal Industry Co., Ltd.,https://www.senju.com/en/products/soldering_materials/solder_paste/
- JPP Series | Solder paste | Lead-free solder | Products | Senju Metal Industry Co., Ltd., https://www.senju.com/en/products/ecosolder/paste/jppSeries.php
- SMIC LEAD FREE SOLDER CATALOGhttps://www.senju.com/ja/download/pdf/SMICcat2018_ESall_E.pdf
- SMIC LEAD FREE SOLDER CATALOGUE, https://www.senju.com/ja/download/pdf/SMICcat2020_ESall_EN_0406.pdf
- T A M U R A R E P O R T, https://www.tamuracorp.com/global/ir/library/tamura-report/pdf/csr_report_2024en_print.pdf
- The effect of rework on brittle fractures in lead-free solder joints – Diva-portal.org, https://www.diva-portal.org/smash/get/diva2:283345/FULLTEXT02
- (PDF) Comparing SAC and SnCuNi Solders in Lead-Free Wave Soldering Process – ResearchGatehttps://www.researchgate.net/publication/267559032_Comparing_SAC_and_SnCuNi_Solders_in_Lead-Free_Wave_Soldering_Process
- US5904782A – Epoxy based, VOC-free soldering flux – Google Patentshttps://patents.google.com/patent/US5904782A/en
- SOLDERING PASTE FLUX AND SOLDERING PASTE – Patent 2716404 – EPO,https://data.epo.org/publication-server/rest/v1.1/patents/EP2716404NWA1/document.html
- Lenovo is cutting emissions while creating cost savings – We Mean Business Coalition, 、 https://www.wemeanbusinesscoalition.org/blog/lenovo-is-forging-ahead-with-climate-action/
- In-Depth Analysis and Professional Repair Guide for Lenovo Laptop Low-Temperature Soldering Failures – Oreate AI Blog, https://www.oreateai.com/blog/indepth-analysis-and-professional-repair-guide-for-lenovo-laptop-lowtemperature-soldering-failures/d58b8e53ee88e199b1ad32ec4b5083b8







